

13917361033
13917361033
在现代电子制造行业中,BGA(Ball Grid Array,球栅阵列)封装的应用越来越广泛。由于BGA封装的复杂性和高密度,传统的手工焊接和返修方法已经无
在现代电子制造行业中,BGA(Ball Grid Array,球栅阵列)封装的应用越来越广泛。由于BGA封装的复杂性和高密度,传统的手工焊接和返修方法已经无法满足高质量和高效率的需求。激光BGA返修作为一种全新的芯片元器件返修技术,通过激光精确的温度控制和先进的操作系统,实现了对BGA元器件的高效、精准返修。
传统红外及热风在对BGA芯片进行拆卸及焊接时,存在温度及热风风向的不可控性,容易造成相邻或是背贴BGA芯片二次超温重熔,造成BGA芯片性能失效。
激光BGA返修系统是激光经过扩束、反射、聚焦后作用于芯片表面,表面热量集聚通过热传导向内部扩散,通过数字化精确控制激光脉冲的宽度、能量、峰值功率和重复频率等参数,使锡球和焊点达到熔点后熔化,从而实现对加工件的拆焊。
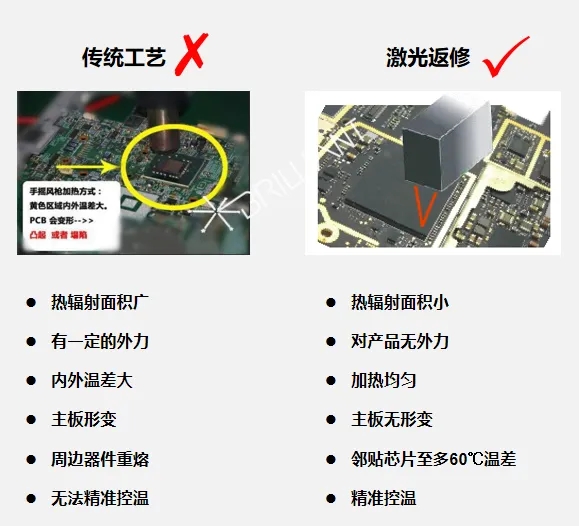
6.激光非接触式加热及热辐射面小,再加上同轴温控的独特性,保证临贴、背贴BGA内锡球的温度低于200℃。可任意变换加工路径的方便性,能适应不同大小尺寸的BGA拆焊。
上一篇:深南电路:FC-BGA封装基板具备14层及以下产品批量生产能
下一篇:多用汽油起球移栽机汽油移栽机挖树机 果树移植机批发
Copyright © 2023 开云网站有限公司 版权所有 备案号:沪ICP备15036269号